做处理器的公司长期以来总是痴迷于把东西弄小。那个著名的——也越来越过时的——摩尔定律“支配”了几十年芯片的发展,或者说芯片的缩小。但是如果有朝一日,“变小”不再像以前那么管用了怎么办呢?相比让处理器中的起见变得更小,英特尔找到了一种“堆起来”的方法。
周三(原文发表于12月12日,所以这个周三应该是指当天),这家芯片巨头演示了名为Foveros的新3D封装技术,能够让在逻辑芯片之上再摞上另一个逻辑芯片。近年来,许多垂直堆叠的技术都在推动存储芯片的发展,但是英特尔是第一家在经过数年的研究之后,把3D堆叠技术大规模地引入CPU、显示芯片以及AI处理器的厂家。估计当年戈登·摩尔爵士预想的肯定不是现今这幅图景——但现实也许比老爷子的想象更好。
叠高高
堆叠式封装不仅仅意味着节省空间,虽然这也是这个技术很大的意义之一。更大的意义在于这个技术允许你根据需求来定制组合不同的硅片。
英特尔的首席架构师Raja Koduri(这大神之前在AMD图形部门,一年前从农企跳到了牙膏厂)说,“你可以在一定的空间里塞进更多的晶体管,也可以塞不同种类的晶体管进去。比如你可以在CPU头上顶一个5G基带,这个堆叠技术就很管用了,能让你在更小的尺寸里获得全部的功能。”
业内的其他厂商也已经注意到了混合搭配晶体管的好处,发明出了类似于在显微镜中才能看见的拼图块一样的“微型芯片(chiplets)”。不过,之前这些依然是对一个平面而言的。现在,英特尔的3D堆叠技术有点像把之前平面上的拼图块变成了能够叠起来的乐高砖。
“这让整个芯片架构的概念都变了!”说这话的是Maribel Lopez,他是一家叫做Lopez Research的技术研究公司的创始人。
而这种变化能带来实实在在的好处。Moor Insights & Strategy的CEO Patrick Moorhead说,之前的2D方式为了一定的灵活性牺牲了性能,而且功耗也更大。而现在看起来英特尔似乎躲过了这些问题。“现在演示中最令人惊讶的就是,他们把这些微型芯片堆起来的时候既没有损失性能也没有增加功耗,”,Moorhead说道,他还表示,英特尔需要证明他们在生产成百上千万的芯片时依然能有这个结果,而不是仅靠一个演示。
而供电问题,则是英特尔宣称已经解决的另一个难题。业界已经追寻3D封装技术几十年了,但一直受限于功耗、发热和价格。Koduri提到,“底层芯片发热后,热量会向上传导。而在3D堆叠封装中,如果你在把所有芯片都组装好了之后发现其中某一层芯片有问题,那就只能整个丢弃了。这可是件代价非常、非常高昂的事儿。”
而至于英特尔是具体怎么解决这些问题的,Koduri则守口如瓶。但他也透露,公司通过严格的测试、新的供电流程,以及完全重新发明的绝缘散热材料来躲过了之前的那些坑。
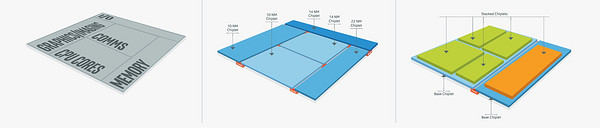
芯片封装技术由平面到3D的转变。Credit:Intel.
大变革
某种程度上,英特尔其实是解决了个一直以来令人头疼的物理问题。而这个问题本身就很有意思。但既然是一项重要突破,那解决这个问题之后能做什么则更加意义非凡。
“随着芯片里的东西越来越小,或者有点什么新型的结构,物理学方面那些有意思的挑战就总会冒出来。”Lopez说道,“解决这些东西才能搞出些新玩意,比如可折叠、可弯曲的设备,或者减轻点重量什么的。”
对了,提醒一下,这些新玩意来得可能比你想象的要快。英特尔说搭载Foveros架构的新产品将在未来12到18个月内发货。而到了那时候,三星大概已经把首个可折叠手机卖到世界各地了。
但是,这种新架构可能会在某些更为微妙的地方带来点好处。因为这个新架构允许制造商调整晶体管的类型来满足自身需求,无数的设备可能都会因为这个堆叠技术而变得更加高效。
Koduri说:“为高性能游戏CPU准备的晶体管放在GPU上未必就是最好的。同样,用在5G基带和设备互联上的晶体管也都不一样。”人工智能方面的需求也不一样,如此等等。“之前,我们只能妥协一下,找一个在各方面表现都还不错的平衡。如今,我们终于能给每一个功能都用上最合适的组件,然后打包封装在一起了。而且因为每个芯片之间的带宽非常大,这堆东西工作起来就和单一的芯片没啥区别。”
长期来看,这种可定制性会让英特尔获益匪浅。即便在如今这家芯片巨头具有统治地位的服务器市场,它也面临着来自Google和亚马逊等其他公司的竞争,这些对手最近也都选择自研处理芯片了。这回,英特尔可以拿出点独门秘籍了,提供了一点让他们成为合作伙伴而不是竞争对手的潜在可能性。
Moorhead则说,“Facebook、Google或者亚马逊没有理由不在Intel的设计中加入自己定制的、专有的芯片。”
当然,就像其他新技术一样,英特尔虽然声称能够在大规模生产中应用Foveros技术,但它仍然需要实际做出来才能证明自己。而且设备制造商和其他合作伙伴也得参与进来。毕竟,英特尔基本上错过了整个移动设备的时代,而且面临着来自AMD、高通和台积电(TSMC)的激烈竞争,其中有些对手已经跳进了7nm制程,而英特尔自己还在磨叽10nm。
但最终,3D堆叠封装带来的最大改变,就是“变小”已经不是厂商们要追求的东西了,取而代之的是“变高”。周三,英特尔还推出了其他一些新的迭代产品,包括新的Sunny Cove CPU架构和Gen11 集成显卡。但是3D封装技术带来了一些革命性的东西:重新思考该怎么造芯片,以及让摩尔定律重新上路的新引擎。
